今天讲讲静电卡盘(ESC)(静电吸附卡盘)
我又回来了,半导体设备开更
一.常见静电吸盘的构造和原理:
1。种类:基本分为两类。即库仑类和迥斯热背(JR或Johnsen-Rahbek)类。
两类吸盘都靠静电荷的同性相吸来固定硅片;吸盘与晶片接触的表面有一层电介质。多采用陶瓷,纯电介质做成的吸盘为库仑类,参杂电介质做成的吸盘为迥斯热背类


2. 工作原理
ESC的实际应用分为单极性和双极性(一般都有偏置电压)
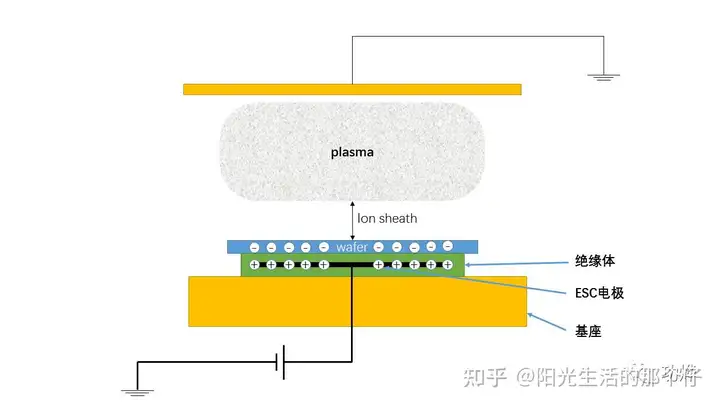
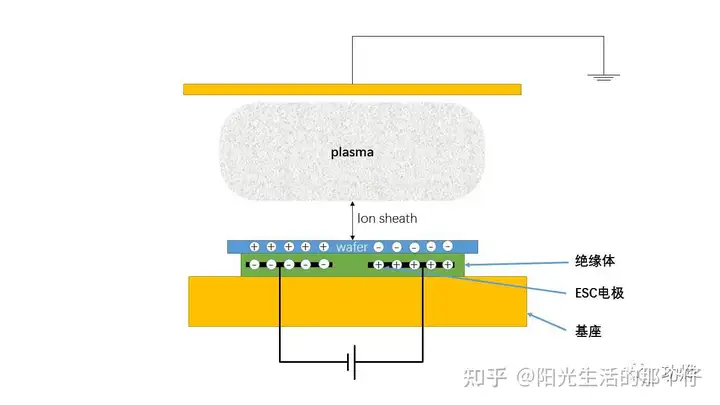
在吸盘的电介质层中镶嵌着一个直流电极(大小与硅片相当,稍小),用以接通到高压(低流)直流电源。
(1)吸住原理
在没有等离子体的情况下,当直流电极被接通到高压(低流)直流电源后,电介质的表面会产生极化电荷(对库仑吸盘而言)。如果是迥斯热背类吸盘,电介质表面不仅有极化电荷,还有很大部分自由电荷,这是因为JR吸盘的电介质有一定导电性。电介质的表面电荷会产生电场,这一电场会进一步在置于吸盘之上的晶片表面产生极化电荷 (也可能包括部分自由电荷,取决于什么样的晶片及晶片表面是什么膜,有导电性或绝缘),分布在晶片背面的电荷与分布在吸盘上面的电荷极性相反,这样晶片解就吸盘吸住了。
(2)释放原理
a.在没有等离子体的情况下,如果关掉被接通到直流电极(镶嵌在吸盘的电介质中)的高压(低流)直流电源,假若分布在晶片背面的电荷与分布在吸盘上面的电荷都是极化电荷,则晶片就被释放了,即吸力自动消失。
b.在没有等离子体的情况下,假若分布在晶片背面的电荷与分布在吸盘上面的电荷中有一部分是自由电荷,即使关掉被接通到直流电极(镶嵌在吸盘的电介质中)的高压(低流)直流电源,则晶片也不会完全被释放,即因残留电荷而仍存在一定的静电吸力。这种情况下,通常需要用反向的静电压来强制消除残留电荷,然后才能释放晶片。
c.在有等离子体的情况下,由于直流自偏压(self DC bias)的缘故,即使关掉被接通到直流电极(镶嵌在吸盘的电介质中)的高压(低流)直流电源,即在吸盘电压为零的情况下,晶片仍然会被吸盘·吸住。这是因为直流自偏压起到了吸盘电压的作用。在某些反应腔中(不是蚀刻机的),甚至不需要用高压(低流)直流电源的静电压,完全靠直流自偏压就足够完成吸住晶片的任务。所以,在处理完晶片后,需要一个释放菜单(dechucking recipe)来释放晶片,否则无法从反应腔中把晶片取出。
3. ESC特性
一般来说,迥斯热背类吸盘的吸力比库仑类的大。在对晶片温度控制要求很高的蚀刻机中,越来越多地采用迥斯热背类吸盘,其电介质通常是参杂的氮化铝陶瓷材料。氮化铝有很好的导热性。
晶片处理过程中,之所以需要把晶片牢牢地吸到吸盘表面,主要是增加晶片与吸盘之间的传热。此外,晶片背面与吸盘表面之间的氦气是传热的重要媒介。
在吸盘中,除了直流电极外,还有射频电极。射频电极用来提供晶片处理过程中需要的射频偏置功率。有些使用的时候,ESC与电极通过一个滤波器相连接。
此外,吸盘中也需要冷却液的循环渠道和氦气的气道。其设计还是需要特别小心细致的。而且,它的设计受到别的方面的制约,如体积不能过大,否则会堵塞或降低反应腔的排气速度。bias HE的设计就又是另一篇了。
以上内容参考了网友的答案,感谢
Long_龙1993Long_龙1993,anchire1948。
(一下内容为工作中新的进展,给大家汇报一下)
二. 静电卡盘最新进展
除了以上两类常见的卡盘,随着LED和三五族元素化合物的wafer的大量应用场景的出现,特别是玻璃、蓝宝石等低导电率的Wafer的出现,传统靠库仑力吸附的卡盘,从原理上对于玻璃、蓝宝石类的负载吸附和释放chuck/Dechuck,开始出现吸不住,放不开的问题。
为了解决这个问题,从原理上放弃库仑力的吸附原理,使用不依靠负载导电性的原理来实现,同时必须配合专用的高压电源和专用的chuck/Dechuck控制算法,才能更可靠的吸附和释放chuck/Dechuck,并对反应腔室的参数进行检测和判断,可以有效降低破片率。
以上就是关于《今天讲讲静电卡盘(ESC)(静电吸附卡盘)》的全部内容,本文网址:https://www.7ca.cn/tg/42804.shtml,如对您有帮助可以分享给好友,谢谢。





